Malzeme Karakterizasyon Laboratuvarı
Taramalı Elektron Mikroskobu (SEM)
FEI QUANTA FEG 250
Malzemenin topoğrafi ve kompozisyonu hakkında bilgi verir.Düşük / yüksek vakum ve ESEM olmak üzere üç farklı vakum modunda ölçüm alabilmektedir. Malzemelerin yüzey morfolojilerinin incelenmesi yanında element (EDS (EDAX)) analizi de yapabilir.
 |
|
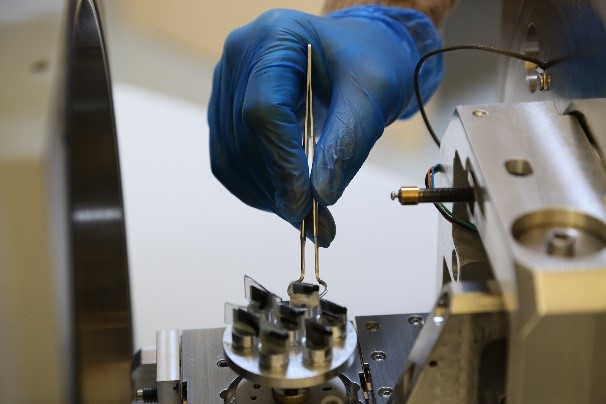
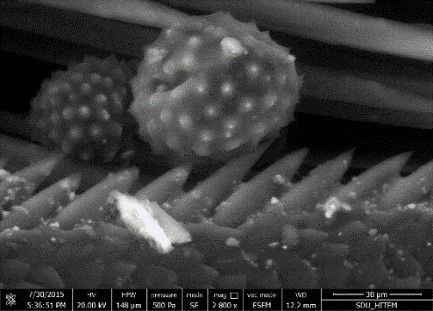
X-ışını Kırınım Laboratuvarı (XRD)
BRUKER D8 ADVANCE TWIN-TWIN
X-ışını kristalografisi;kristalleşmiş atomların X-ışınıdemetindeki ışınların kristale özel çeşitli yönlerde kırınımı olayına dayanan, bir yöntemdir. Toz, ince film, bulk malzemeler analiz edilebilmektedir. Ayrıca stres ve sıcaklığa bağlı (0-1300 oC) ölçümler yapılabilmektedir.
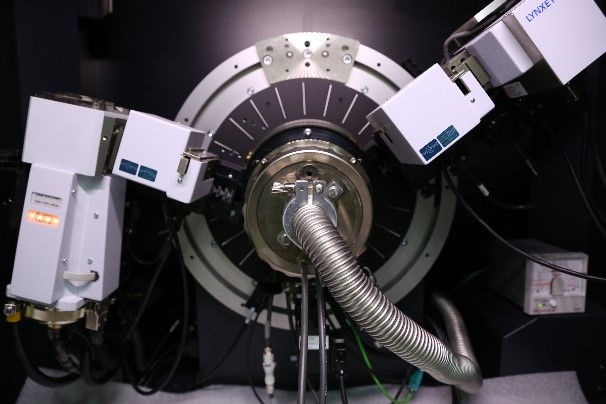 |
- Toz kırınım tablası - Sıcaklık bağımlı ölçüm tablası - Eğilim özellikli tabla (3 eksenli beşik Chi, Phi, z) |

Atomik Kuvvet Mikroskobu Laboratuvarı (AFM)
ez-AFM Nanomagnetics
Atomik kuvvet mikroskobu, malzemelerin yüksek çözünürlüklerde 3 boyutlu yüzey morfolojisini incelemektedir. Ulaşılan maksimum çözünürlük nanometreölçeğinde olup optik tekniklerden en az 1000 kat hassastır.
AFM cihazı ile yüzey morfolojisinin incelenmesinin yanında profilometre kipi ile de malzemelerin kaplama kalınlıklarını tespit edebilmektedir.
 |
|


Elektro-Optik Karakterizasyon Laboratuvarı
CRYO In. (Sumitomo) / Keithley / Solar Light /Agilent /Lake Shore / SP
Malzemelerin elektriksel, manyetik ve optik özelliklerini analiz etmede kullanılmaktadır.
 |
|
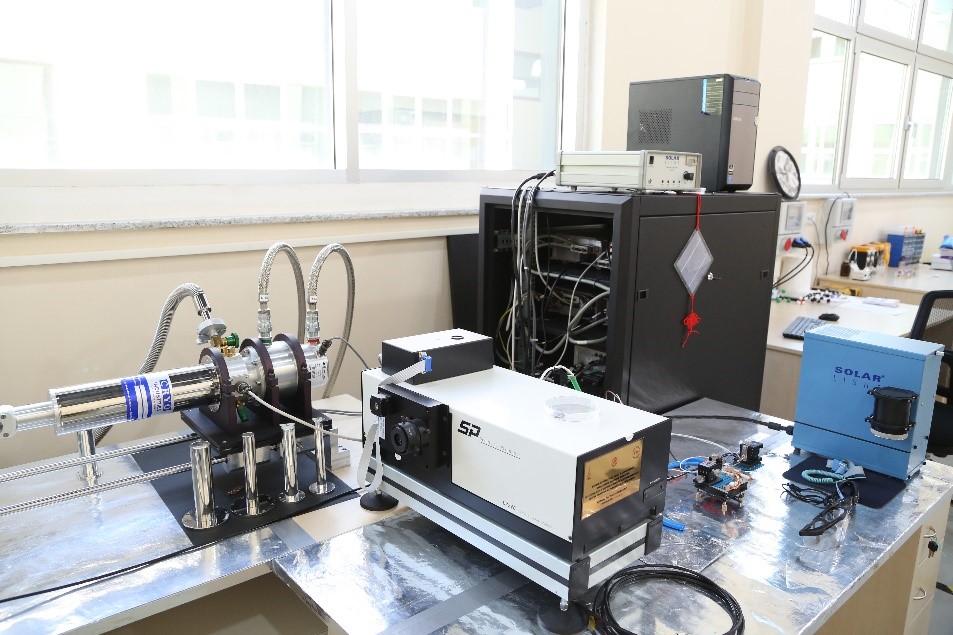



Termal analiz (TG), belirli bir atmosferde numunenin sıcaklığı programlanırken, numunenin bir özelliğinin zamana veya sıcaklığa karşı izlendiği bir analiz türüdür. Bir numunedeki kütle değişimini ölçmek, buharlaşma, ayrışma, oksidasyon ve kütle değişimine neden olan diğer sıcaklıkla değişim etkilerini tespit etmek için kullanılır. Bununla birlikte Diferansiyel Tarama Kalorimetrisi (DSC), camsı geçiş sıcaklığı, erime ve kristalleşme sıcaklıkları gibi geçişlerin ölçülmesini sağlar. Ayrıca, termal kürleme, ısı geçmişi, özgül ısı kapasitesi ve saflık analizi gibi kimyasal reaksiyonlar da ölçülebilir. DTA ve DSC, numune ile referans arasındaki sıcaklık farklarını tespit eder; ancak DSC, üstteki ısı miktarının nicel ölçümünü de gerçekleştirebilir.
Merkezimizde bulunan HITACHI NEXTA STA 300 cihazı ile oda sıcaklığı-1500 ºC aralığında azot ortamında, <10 ug çözünürlüğünde kütle kaybı (mg/%) ve bozunma sıcaklığı tayini yapılabilmektedir.
